天游web原生态手机端-4501是配备热电子枪型SEM和高性能离子镜筒的复合束加工观察装置。虽然可以直接使用SEM观察样品的表面,但可以通过在使用FIB对截面进行局部加工后进行SEM观察来进行内部观察和元素分析。此外,还可以制备使用 FIB 和 TEM 薄膜样品的微加工。大腔室的使用扩大了应用范围。此外,低真空模式允许SEM观察而无需涂覆任何绝缘体,使其适用于所有领域。
功能
结合热电子枪SEM和高性能FIB进行综合分析
天游web原生态手机端-4501 采用高功率 FIB 镜筒,最大离子束电流为 60 nA,可实现高速处理。可以加工更大面积的截面,并可在现场进行SEM观察、EDS*分析、EBSD*分析。由于一系列操作可以在同一真空中进行,因此可以在不受氧化等表面劣化影响的情况下对材料进行分析。此外,大载物台允许插入直径为 75 毫米、高度为 30 毫米的样本,而无需切割。
(*)可选附件
串行切片和采样功能
天游web原生态手机端-4501的立柱排列设计使得可以在倾斜载物台的情况下进行SEM观察,同时FIB处理的横截面保持不变,因此使用FIB的横截面处理和SEM图像采集的一系列操作可以自动连续地进行。如果您使用可选的应用软件“Stack N Viz”,您可以将其重建为 3D 图像,让您以 3D 方式了解样品的内部结构。
与其他 JEOL 产品的兼容性
天游web原生态手机端 系列具有与 JEM 系列** 和 JSM 系列** 兼容的选项。使用 天游web原生态手机端 系列制备的样品可以在 JEOL 产品之间以高通量传输,从而轻松执行更详细的分析。例如,如果使用穿梭固定器互换 JEM 系列的 TEM 支架(例如 JEM-ARM200F)的尖端和 天游web原生态手机端-4501 的载物台(图 1),则无需对安装在半月形网格上的 TEM 样品进行精细处理,从而进一步提高吞吐量。
**仅限于某些产品
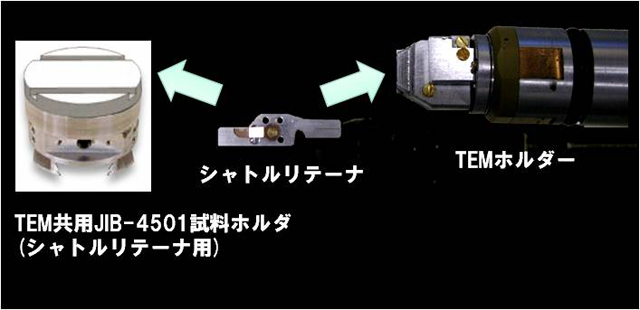
图1 天游web原生态手机端-4501与JEM系列兼容示例
应用示例
应用1 片式电容器结界面的截面观察及EDS分析
通过将热电子枪SEM、高性能FIB和EDS安装在同一室中,可以同时进行截面处理、SEM观察和EDS分析。图 2 和图 3 显示了片式电容器焊点界面相同位置的截面 SEM(背散射电子成分)图像、SIM(扫描离子显微镜)图像和 EDS 元素图。在 SEM 背散射电子成分图像中可以清楚地观察到原子序数对比。另一方面,在 SIM 图像中可以清楚地观察到 Cu 区域的沟道对比度。
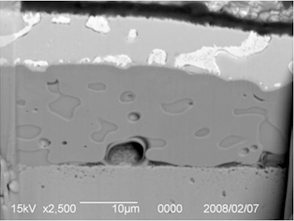
SEM(背散射电子成分)图像
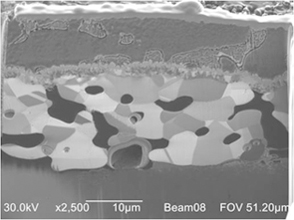
SIM(在显微镜下扫描)图像
图2 片式电容器接合界面的截面观察(SEM、SIM)

元素映射图像
图3 片式电容器接合界面的截面EDS分析
应用 2 高质量 TEM 样品制备
使用 天游web原生态手机端 系列的高性能 FIB 色谱柱可以制备高质量的薄膜样品。图4显示了使用30 kV的Ga离子束加速电压制造的Si(110)取向的STEM明场图像(左)和HAADF图像(未使用低加速电压或Ar离子照射进行精加工)。
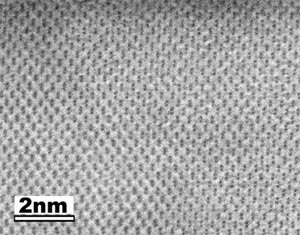
明场图像
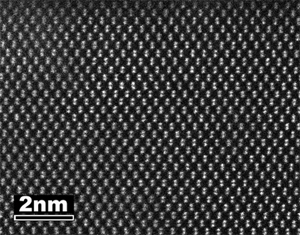
HAADF 雕像
图 4 Si (110) 的 STEM 图像 (JEM-ARM200F)
规格/选项
FIB(聚焦离子束)
| 离子源 | Ga液态金属离子源 |
|---|---|
| 加速电压 | 1~30kV(阶跃) |
| 放大倍数 | ×30(用于视野搜索) ×100~×300,000 |
| 图像分辨率 | 5nm(30kV) |
| 最大束流 | 60nA(30kV 时) |
| 可移动光圈 | 12级(电机驱动) |
| 离子束加工形状 | 矩形、线条、点 |
SEM(电子束)
| 光束源 | 实验室6 |
|---|---|
| 加速电压 | 03~30kV(阶跃) |
| 放大倍数 | ×5~300,000 |
| 图像分辨率 | 25nm(30kV) |
| 最大束电流 | 1μA(30 kV 时) |
| 样品台 | 测角仪平台X:76毫米,Y:76毫米Z:5~48mmT:-10~90°,R:360°R:360°无尽最大样品尺寸:76mmφ |
主要附件
暗室范围侧面使用
顶面腔室范围
注气系统2
外部扫描接口
EDS
大气拾音系统



