天游web原生态手机端 X射线荧光分析(XRF)原理
什么是 天游web原生态手机端荧光分析 (XRF)
X射线荧光分析原理
物质与 天游web原生态手机端的相互作用
天游web原生态手机端和光一样,是电磁波的一种。可见光的波长为400~800nm,但X射线的波长较短(能量较高),为0001nm~10nm,已知具有较强的穿透力。
图 1 显示了物质与 天游web原生态手机端之间的相互作用以及利用它的各种分析方法。这些相互作用为材料状态提供了重要线索,最熟悉的例子是医学 天游web原生态手机端摄影,它使用透射 天游web原生态手机端。
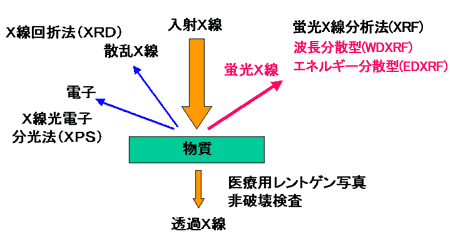
图1 X射线与物质之间的相互作用以及使用它的分析方法
X射线荧光分析
当材料受到 天游web原生态手机端照射时,会产生荧光 天游web原生态手机端(特征 天游web原生态手机端),其具有构成该材料的元素所特有的能量(波长)。通过测量该荧光X射线的能量,可以确定所含有的元素(定性分析),并且可以根据荧光X射线的强度计算出各元素的浓度(定量分析)。 X射线荧光分析是通过用X射线照射未知物质并测量产生的荧光X射线来对未知物质进行定性或定量分析的方法。
荧光X射线分析方法有两种类型:使用分光晶体的波长色散型(WDXRF)和使用半导体检测器(EDS)的能量色散型(EDXRF)。
波长色散型(WDXRF)和能量色散型(EDXRF)之间的区别
波长色散装置(WDXRF)具有高灵敏度、高精度、高分辨率、高再现性的特点。您可以预期其灵敏度和精度比能量色散设备 (EDXRF) 高一个数量级。这些特性由高功率 天游web原生态手机端管(3-4 kW)及其冷却系统、具有复杂运动的测角仪以及用于更换光谱晶体和探测器的机构来维持。当然,设备更大、结构更复杂、价格也更贵。样品表面要求平坦,分析面积范围从几毫米到30毫米,适合测量许多相同形状样品的过程控制。能量色散装置(EDXRF)的特点是结构简单、成本低廉、能够处理多种样品,并且易于任何人使用。 X射线管体积小(几十W),风冷,并且没有复杂的光谱部分,因为它使用单个EDS(半导体探测器)进行光谱分析。可以分析大样本和微小零件,而不必担心不规则或不规则形状。各自的特性如图2所示,可以看出WDXRF是大型设施,而EDXRF是小型且简单的设施。
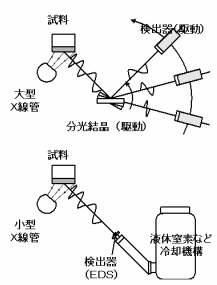
图2 波长色散型(WDXRF)和能量色散型(EDXRF)的比较
波长色散型(WDXRF)
优点:高灵敏度、高分辨率高精度、高重复性缺点:复杂、大规模、昂贵仅限平板样本
能量色散 (EDXRF)
优点:操作方便、体积小、价格便宜样品形状自由度大缺点:分辨率低(重叠峰)需要液氮等冷却机制
固体/粉末/液体样品取样
EDXRF 的特点之一是易于采样。下面解释了固体、粉末和液体样品的取样。
固体样品取样
只需将固体样品放置在 天游web原生态手机端照射位置即可进行分析。对于小样品,您可以使用专用样品池轻松设置样品。图 3 显示了固体样品的简单采样方法。
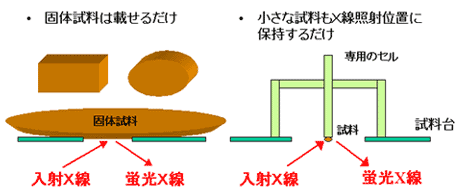
图3固体样品的取样
粉末样品取样(岩石、土壤、焚烧灰等)
粉末样品通常通过使用压力成型装置生成颗粒进行分析。通过在专用池中填充粉末即可轻松进行分析。图 4 显示了粉末样品取样的简单方法。
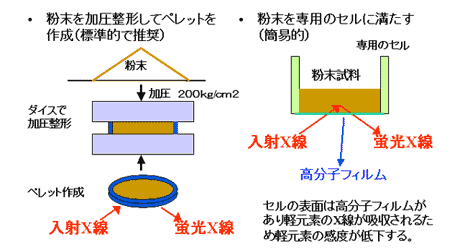
图4粉末样品的取样
液体样品取样
使用充满液体的特殊单元来分析液体样品。另一种方法是将液体滴到过滤器上并干燥以进行分析。图 5 显示了液体样品采样的简单方法。
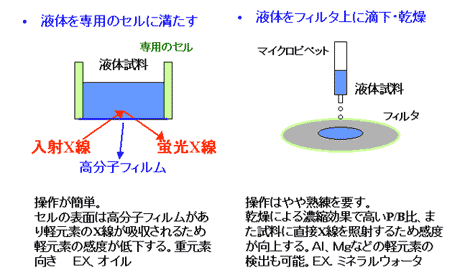
图5液体样品的取样
使用FP(基本参数)定量方法进行定量分析
EDXRF设备采用称为FP定量法的理论计算方法,使得在测量未知样品时无需标准样品即可轻松进行定量分析。
FP定量方法假设样品是均匀的,样品足够大和厚,并且所有元素都被定量(总计100%)。当然,样本也必须满足这些先决条件,因此必须小心。
FP定量方法的流程图如图6所示。
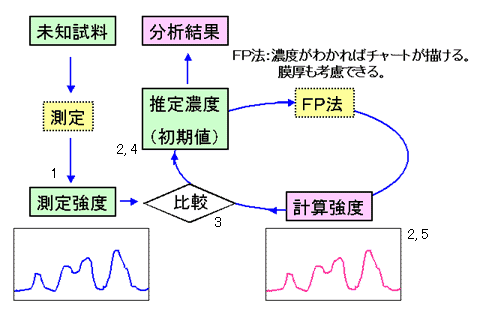
图6 FP定量法流程图
FP定量法流程
首先,测量未知样品以获得测量的强度。假设样品的初始浓度,使用 FP 方法获得计算的强度。比较测量的强度和计算的强度。更改估计浓度,以便测量的强度和计算的强度匹配。使用 FP 方法和新的估计浓度获得新的计算强度。重复步骤 3 到 5。测量浓度与计算浓度一致时的推定浓度为分析结果。
薄膜材料的厚度分析
对于薄膜样品,薄膜构成元素的X射线强度与膜厚呈正相关,因此通过从薄膜表面照射X射线,测量薄膜构成元素的X射线强度,可以无损分析膜厚。
单层膜可以使用校准曲线法进行分析,但校准曲线法需要为每种类型的膜制备标准样品。薄膜 FP 定量方法极其方便,因为它不仅可以进行单层薄膜分析,还可以分析最多 5 个多层薄膜的每一层的厚度和成分,而无需标准样品。图7为薄膜FP法的示意图,图8为Au/Ni/Cu膜的测量示例。
薄膜FP(基本参数)法
薄膜厚度和成分的同步无损分析最多5层,每层最多20种成分膜厚约为10 nm至10 μm(取决于元件)无需标准样品(理论计算)需要有关薄膜堆叠顺序、薄膜成分和密度的信息
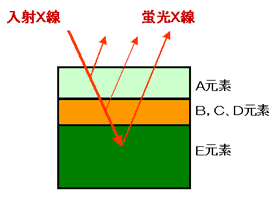
图7薄膜FP法示意图
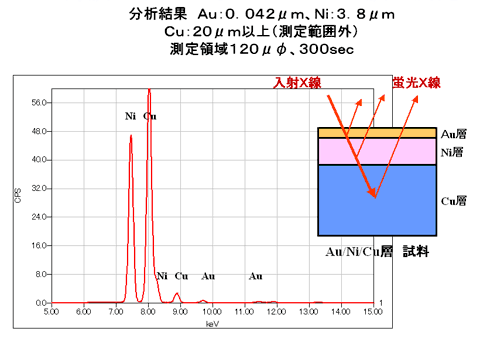
图8 采用薄膜FP法测量Au/Ni/Cu薄膜
相关应用笔记
使用 天游web原生态手机端荧光分析检查和分析树脂表面的异物 - 使用 XRF 和 SEM-EDS 进行异物分析 -
利用FP法对塑料中所含无机元素进行定量和定性分析-有机标准样品的测量示例-



