适合研发的电子束蒸发装置。通过添加各种可选机制,它可以用于多种用途。蒸发源可选用电子束蒸发源(电子枪)、轰击蒸发源、电阻加热蒸发源。也可以组合电子枪和轰击沉积源,或者电子枪和电阻加热源。
功能
电子束蒸发源(电子枪)
可以蒸发电阻加热或感应加热无法蒸发的高熔点金属、低导热率的氧化物、升华性材料等各种无机材料。
由于水冷铜坩埚内部的蒸发材料直接用电子束加热,因此不会与坩埚发生反应。
由于可以高速控制输出,因此可以实现电阻加热无法实现的精确膜厚控制和蒸发速率控制。
与溅射和CVD相比,沉积速率高出一个数量级以上,并且容易沉积1μm以上的厚膜。
您可以选择电子枪、坩埚和电子枪电源。标准EBG-102UB6S电子枪具有高速扫描功能,并配有12ml x 6坩埚。

EBG-102UB6S
电子枪和背散射电子陷阱的组合
通过结合电子枪和背散射电子陷阱,可以显着减少进入基板的背散射电子量。
通过减少背散射电子,可以预期以下效果。
可以抑制电路板温度的上升。适用于沉积在抗蚀剂图案上的剥离工艺。
适合涂覆在易受背散射电子损伤的基材和底层上。
提高附着力。
电子束蒸发过程中的抗蚀剂变形是由入射背散射电子引起的温度升高引起的。
背散射电子陷阱抑制背散射电子并实现稳定的剥离沉积。最适合形成MEMS等电极膜。
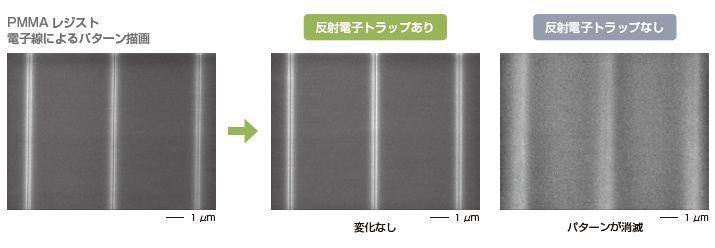
轰击沉积源
用电子束照射填充有气相沉积材料的衬里的背面,并通过电子轰击加热衬里。
请勿将电子束直接施加到沉积材料上。由于它是间接加热方式,因此具有以下特点。
可以抑制背散射电子和X射线的伤害。
普通电子束蒸发即使使用容易飞溅的蒸发材料也可以生产低缺陷薄膜。
由于是间接加热,因此即使是在电子束照射下会分解的蒸镀材料也不会发生分解或成分变化。
由于沉积材料没有分解,因此光吸收率较低。
通过电子束间接加热可以控制速率。与电阻加热相比,它可以形成更稳定的薄膜。
对高熔点金属等蒸发材料有限制。
轰击法加热原理(示意图)

产品信息
电阻加热沉积源(可选)
最多可安装2台(输出功率:3kW)。
不能同时存入两个单位。
基材支架
我们根据所需的板尺寸和板数量制造板支架。
[生产示例]
中心驱动板支架旋转(平板型)最大可容纳 φ4 英寸板 x 4 件套
行星板支架旋转旋转单元 x 3 个位置(每个单元可设置 3 个 2 英寸板)
可以互换使用。
我们还可以处理电路板尺寸和电路板数量的变化、电路板加热、电路板冷却、电路板支架倾斜等。

平板支架

行星穹顶
控制系统
(标准)使用晶体膜厚控制器自动成膜
可以将薄膜沉积过程编程到薄膜厚度控制器中,高精度地控制薄膜的形成速度和厚度。
晶体膜厚传感器可以选择单传感器或双传感器。
也可以通过手动操作进行光束输出。
您可以通过触摸面板执行以下操作。
全自动排气
坩埚驱动和基板旋转机构的控制和状态显示
各种联锁/报警状态显示

射频电源(可选)
射频电源RF-12010(750W)
可以产生等离子体并进行离子镀膜形成。它提高了附着力和薄膜密度,从而可以形成高功能薄膜。
a) 线圈类型:放置在电子枪坩埚和基板之间的线圈
b) 基材应用方法:射频应用到基材支架
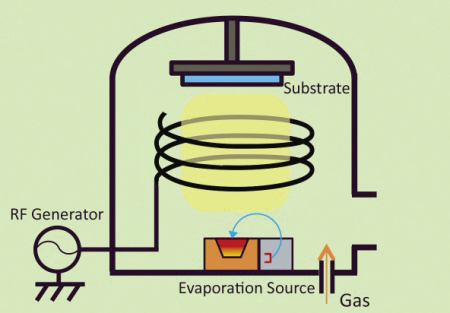
线圈类型
光学膜厚监测仪(可选)
可安装光学膜厚监测仪。
您可以选择滤波器切换类型和光栅类型。
炉衬(可选)
可以安装衬里来改变坩埚容量。
通过炉床衬里提供隔热效果,即使在低输出下也更容易获得恒定的蒸发速率。
还有可以反复沉积铝的衬里。
加载锁(可选)
允许更换基材,同时保持沉积室处于真空状态。
设置在装载/卸载室中的基板可以通过操作开关自动设置到沉积室中。
自定义规格(可选)
我们可以根据客户的规格进行制造,因此请单独联系我们。
规格/选项
规格

| 项目 | 盒型 | 钟罩型 | 多同时沉积型 | 连续卷绕式(卷对卷) |
|---|---|---|---|---|
| 蒸发源(标准) | EBG-102UB6S电子枪×1JST-10F电子枪电源×1 | EBG-102UB6S电子枪×1JST-10F电子枪电源×1 | EBG-203UB6S电子枪×2JST-10F电子枪电源×1 | JEBG-303UA电子枪×1JST-16F电子枪电源×1 |
| 蒸发源(可选) | 电阻加热×2 | 电阻加热×2 | 电阻加热×3 | 轰击沉积源 |
| 腔室尺寸 | φ500mm×770mmH | φ500mm×500mmH | φ750mm×1,000mmH | 宽695毫米×深520毫米×高975毫米 |
| 包含的项目 | 晶体膜厚控制器 | 晶体膜厚监测仪 |
晶体膜厚控制器(2-5 单位) 基板加热机制
|
(可选)晶体膜厚控制器 |
| 基材支架 | 中心驱动基板旋转(平板)行星板自转 | φ200mm平板 | 中心驱动基板旋转(平板) | 基材宽度:130mm最大收卷直径:φ150mm |
| 真空性能 | 极限压力:8×10-5Pa以下,成膜压力:5×10-2Pa 或更低 | |||
| 排气系统 | 涡轮分子泵(1,400L/秒)×1、旋转泵×1 | 油扩散泵×1机械增压泵×1旋转泵×1 | 油扩散泵×1旋转泵×1(可选)涡轮分子泵低温板 | |
| 安装尺寸 | 宽2,000毫米×深1,000毫米×高2,200毫米 | 宽1,800毫米×深1,000毫米×高2,450毫米 | 宽4,000毫米×深4,000毫米×高2,500毫米 | 宽2,400毫米×深1,300毫米×高1,900毫米 |
| 总质量 | 小于 1,200 公斤 | 大约。 960公斤 | 2,500公斤 | 小于 1,200 公斤 |
可以根据客户的规格制造,例如安装的设备规格和真空室尺寸。请单独咨询我们。
有关选项,详细信息列于功能部分。
目录下载
图库

相关产品

背散射电子陷阱
在电子束蒸镀过程中,入射到蒸镀材料上的部分电子以反射电子(背散射电子)的形式发射出来,当它们到达基材时,可能会损坏基材、升高温度、降低薄膜附着力。背散射电子陷阱是一种可以与电子枪结合使用的装置,可显着减少进入基板的背散射电子量。它还可以对现有的气相沉积设备进行改造。通过减少背散射电子,可以预期以下效果。
可以抑制电路板温度的上升。适用于沉积在抗蚀剂图案上的剥离工艺。
适合涂覆在易受背散射电子损伤的基材和底层上。
提高附着力。