配备纳米探针的扫描电子显微镜缺陷半导体位置识别进入SEM时代这是一种半导体故障天游ty8检测中心系统,可评估与 65nm 代微工艺兼容的电气特性,检测电阻异常,并使用“纳米操作方法”和“电子束吸收电流方法”修复缺陷区域。
功能
由于样品照射电流可以有很大的变化,因此即使对于低吸收电流的样品也可以获得高质量的吸收电流图像。
作为缺陷部位识别方法,具备吸收电流(电流、电压)检测法、电位对比法、EBIC法等各种功能。
配备电子束辅助打标功能,可精确打标01 µm布线。
可安装CAD导航系统

90nm工艺产品(布线Open)天游ty8检测中心示例
A) 在顶层创建PAD,从实际产品(7层)布局图中获取吸收电流
B) 比较布局图中的布线图案和吸收电流图像中的布线图案以检测异常位置
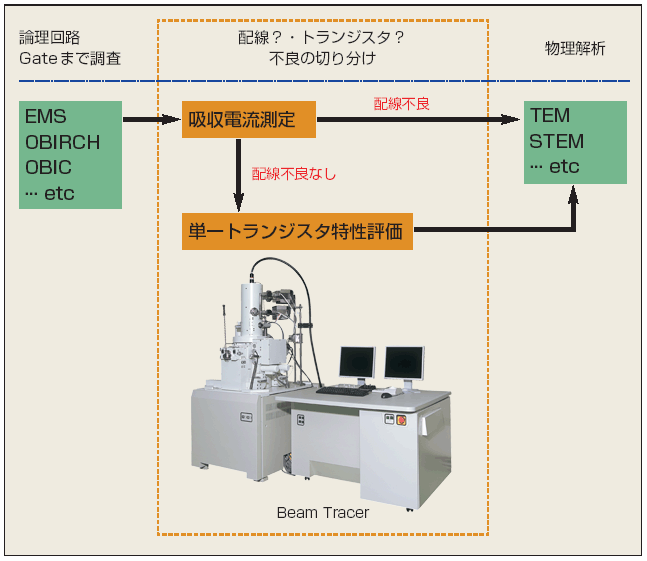
故障天游ty8检测中心流程示例

标记示例
识别出缺陷位置后,通过在任何位置进行精细而准确的标记,可以更轻松地找到该位置以进行后续的物理天游ty8检测中心。

测量屏幕示例
左:二次电子图像,右:吸收的电流图像
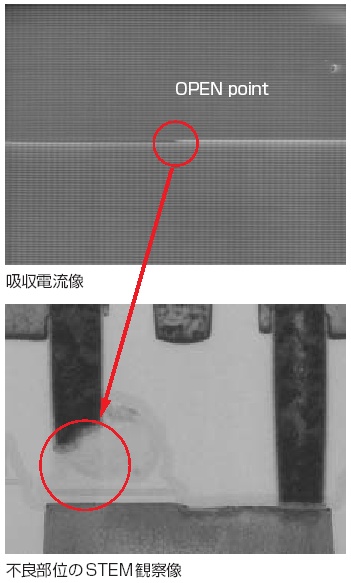
OPEN位置失败天游ty8检测中心示例
规格/选项
| 观测系统 | |
|---|---|
| 探测期间的二次电子图像分辨率 | 3nm(加速电压15kV) |
| 探测时WD | 10毫米 |
| 放大倍数 | ×25~500,000 |
| 雕像类型 | 二次电子图像、吸收电流图像、EBIC图像等 |
| 加速电压、照射电流 | 05~30kV, 10-12~2×10-7A |
| 探测系统 | |
| 行驶距离 | X,Y 20mmZ 15毫米 |
| 最小移动步数 | 5nm或更小 |
| 样本大小 | 芯片20×20mm(最大) |

