这是一款天游web原生态手机端探针显微镜,可在10-8 Pa的超高真空下实现014 nm水平分辨率和001 nm垂直分辨率的高分辨率,以观察真实干净的表面。它是一种高度可扩展的设备,配备了多种外围设备,不仅可以用于简单地观察材料表面凹凸图像,还可以用于观察吸附过程、高低温相变、堆叠结构中的电子密度分布、天游web原生态手机端隧道电子能谱(STS)、原子力显微镜(AFM)等许多应用。
功能
我们通过简化超高真空中的样品处理室创建了紧凑的配置。
变体列表
JEOL 的 UHV-SPM 系列提供多种产品阵容,包括 STM 专用机器、AFM/STM 两用机器以及样品处理室形状,如下所示。
| STM专用机 | AFM/STM dual purpose machine |
|---|---|
| 超高真空天游web原生态手机端隧道显微镜JSPM-4610S | 超高真空天游web原生态手机端探针显微镜JSPM-4610A |
超高真空天游web原生态手机端隧道显微镜(STM专用机)
JSPM-4610S

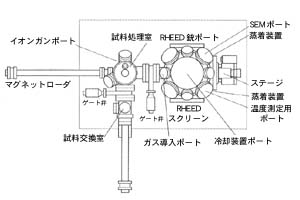
这是JSPM-4610专用的STM机,JSPM-4610是JSPM-4500多端口样品处理室的简化版本。
虽然简化了样品处理室,但样品停放台上最多可以安装两个样品架,并且还可以安装类似于 JSPM-4500 的附件。然而,附件安装受到端口数量和尺寸的限制。
超高真空天游web原生态手机端原子力显微镜(AFM/STM两用机)
JSPM-4610A

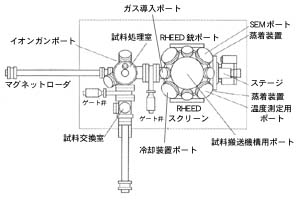
这是JSPM-4610的AFM/STM两用机,它是JSPM-4500多端口样品处理室的简化版本。通过更换探头,它可以兼容AFM和STM,并且可以处理广泛的测量样品。此外,通过使用导电悬臂,可以同时进行 AFM 和 STM 观察。
虽然简化了样品处理室,但样品停放台上最多可以安装两个样品架,并且还可以安装类似于 JSPM-4500 的附件。然而,附件安装受到端口数量和尺寸的限制。
附件
附件兼容性表
| JSPM-4610 | ||
|---|---|---|
| 试料处理室 | 观察室样本 | |
| 样品加热 | 〇 | 〇 |
| 样品冷却 | ― | 〇 |
| 气相沉积设备 | △ | 〇 |
| 气体导入装置 | △ | 〇 |
| 裂解装置样品 | △ | ― |
| XPS 设备 | ― | ― |
| LEED/AES 设备 | ― | ― |
样品加热
通过使用直接向样品通电的直流加热支架(标准配置)或使用PG(热解石墨)加热器(可选)的间接加热支架,可以对样品进行热处理并保持高温观察的温度。
样品冷却
通过使用冷却台,可以在低温下观察样品。冷却台采用液氦和液氮两层冷却方式,与无漂移台相结合,使样品冷却稳定,冷却效率高。
STM专用机(JSPM-4610S)和AFM/SPM两用机(JSPM-4610A)的冷却槽安装位置不同。下图为安装了冷却水箱的 JSPM-4500A。在 STM 专用机器中,冷却箱直接安装在腔室上方。

气相沉积设备
用于将外来原子沉积到样品上的附件。该结构允许从下面对样品进行气相沉积,并且由于样品是准直的,因此可以在不污染样品以外的任何东西的情况下进行气相沉积。它还具有快门功能,因此您可以控制蒸发量。

气体引入装置
这是SPM观察期间观察气体吸附过程和化学反应的有效附件。使用该附件可有效研究吸附的初始过程和吸附气体的分布。
裂解装置样品
该装置安装在样品处理分析室,在超高真空下对特制样品架中的半导体样品等相对硬脆的样品进行劈裂。解理后,可以使用SPM观察解理面。

规格/选项
| 分辨率 | ||
|---|---|---|
| STM | 原子力显微镜 | |
| 水平分辨率 | 014nm | 原子分辨率 |
| 垂直分辨率 | 001nm | 原子分辨率 |
| 粗动功能(电机驱动) | ||
| STM专用机 | AFM/STM两用机 | |
| 逼近函数(Z粗动) | 内置自动接近功能 | |
| X、Y粗动(示例动作) | ±2mm | ±1mm |
| 压电天游web原生态手机端元件(压电元件) | ||
| STM专用机 | AFM/STM两用机 | |
| 天游web原生态手机端方法 | 堆叠共享模式天游web原生态手机端方法 | 管天游web原生态手机端法 |
| 天游web原生态手机端尺寸 | XY=02um, Z=06um | XY=10um,Z=27um |
| 天游web原生态手机端旋转 | 内置(-180° 至 180°) | |
| 天游web原生态手机端范围 | ||
| STM专用机 | AFM/STM dual purpose machine | |
| 天游web原生态手机端变量范围 | 0~200nm | 0~10um |
| 缩放功能 | 内置 | |
| 示例 | ||
| STM专用机 | AFM/STM两用机 | |
| 样本大小(高×宽×厚) | 最大10×10×5mm | 最大8×77×2mm |
| 1×7×03mm(加热用) | ||
| 样品加热机制(标准) | ||
| 加热方式 | 电加热 | |
| 加热温度 | ≦1200℃ | |
| 漂移 | ||
| 阶段方法 | 无漂移阶段方法 | |
| 系统漂移量 | ≤005nm/s | |
| 超高真空室 | ||
| 配置 | 3室配置(3室独立排气系统) | |
| 真空度 | 样品交换室~10-4帕样品处理室~10-7帕超高真空图像观察室~10-8帕 | |
| 烘焙方法 | 内置加热器方式 | |



