
功能
从样品制备到观察分析
提供顺利的工作
增强的FIB处理功能,通过采用新镜筒本质上提高了SEM观察性能,并通过加强协作功能提高了可操作性
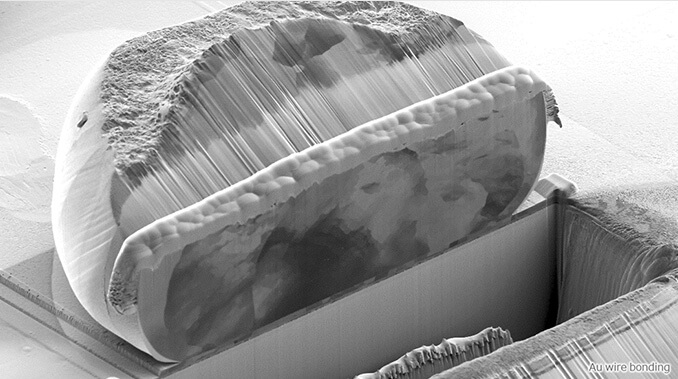
FIB:增强的处理功能
- ·控制系统的改造矢量扫描有利于任意形状的美观加工和稳定的三维观察分析
- ·高达 90 nA 的高电流提供样本的高速处理
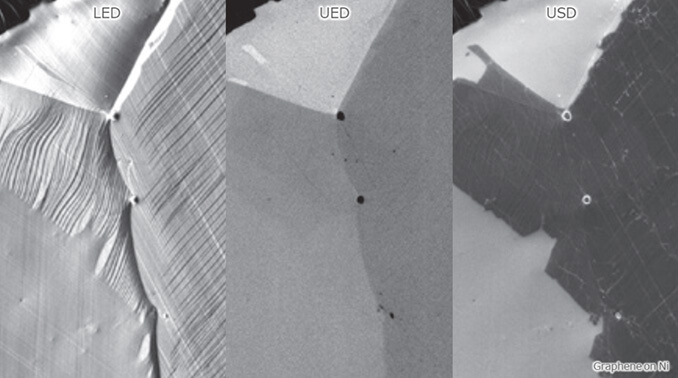
SEM:新镜筒提高了性能
- ·低加速度高分辨率通过天游ty8检测中心混合锥形物镜和 GENTLEBEAM™ 在低加速条件下实现高分辨率 (1 kV/16 nm)
- ·各种图像获取添加了新的 UED/USD 检测器。能够获取反映物理性质、化学成分、晶体结构等的多种SEM图像
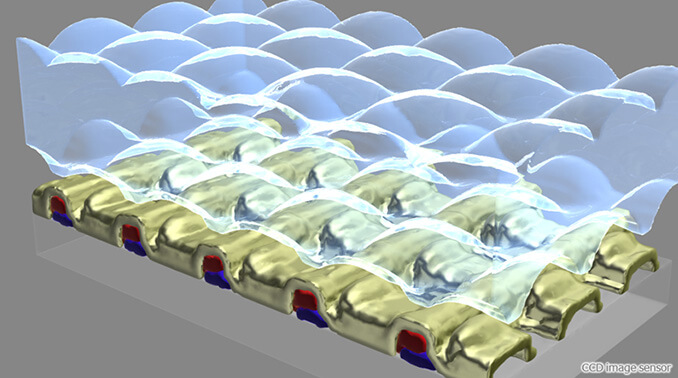
3D:三维观察与分析
- ·控制系统的改造矢量扫描,轻松精美地加工任意形状,并进行稳定的三维观察分析
- ·高达 90 nA 的高电流提供样本的高速处理
申请
FIB-SEM 独有
各种解决方案
提供截面样品制备、TEM样品制备、3D观察、3D EDS、3D EBSD、微形加工等多种应用
横截面
天游ty8检测中心复合光束加工装置JIB-4700F,可以集成进行保护膜制备、样品铣削以及截面观察和分析。FIB镜筒可通过高达90 nA的Ga离子束照射进行加工。高电流加工对于制备大面积样品特别有效。
TEM 样品
JIB-4700F 和机械手系统的结合可以顺利进行 TEM 样品制备。您可以天游ty8检测中心高分辨率 FE-SEM 监控 FIB 处理过程中的状态,而不会影响吞吐量。在制备 TEM 薄膜样品时,我们提供终点检测和深度优化等高效工作。
3D-EDS 分析
天游ty8检测中心垂直于样品表面的 FIB 入射的处理和天游ty8检测中心 SEM 光束的 EDS 分析是自动连续进行的。SEM 镜筒即使在高电流下也能保持高分辨率,从而实现高速 EDS 分析。
3D-EBSD 分析
独特放置的 EBSD 检测器* 无需移动载物台即可进行处理和分析。这可以节省时间并提高数据定位精度。
※可选附件